Laserbasiertes Reballing von BGA-Komponenten
Das Reballing von Ball Grid Arrays (BGAs) mithilfe eines Laserverfahrens stellt eine besonders materialschonende Technik dar. Durch den gezielten Einsatz kurzer Laserimpulse wird das Bauteil keinem thermischen Stress ausgesetzt, was die Anforderungen der IPC-Richtlinien deutlich übertrifft.
Im Vergleich zu herkömmlichen Rework-Methoden ist das Laserverfahren das einzige, das die herstellerseitig vorgegebene Beschränkung auf maximal drei Reflow-Zyklen einhält. Damit eignet es sich besonders für empfindliche oder bereits mehrfach verarbeitete Komponenten.

Die Reballing-Prozedur erfolgt mit einem spezialisierten System, das für die Herstellung von BGA-Kontakten konzipiert ist. Dabei wird der BGA auf einem präzisem und steuerbaren XY-Tisch positioniert. Dieser fährt automatisiert die einzelnen Kontaktflächen (Pads) an.
An jeder Position wird eine exakt dimensionierte Lötperle (Preform) unter Stickstoffatmosphäre mittels eines kurzen, hochenergetischen Laserimpulses angeschmolzen und aufgebracht. Pad und Kugel werden lokal für wenige Millisekunden erhitzt, während das Bauteil selbst während des gesamten Vorgangs bei Raumtemperatur verbleibt.
Nach Abschluss des Kugelauftrags wird eine optische Kontrolle durchgeführt, um die planare Ausrichtung aller Kontakte (Koplanarität) zu verifizieren. Anschließend folgt ein Temperprozess, bevor die Komponenten in einer vakuumversiegelten Verpackung bereitgestellt werden.
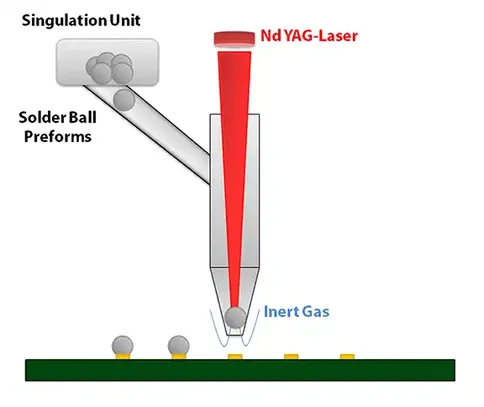
Die Lasertechnologie erlaubt darüber hinaus eine Vielzahl an anwendungsspezifischen Anpassungen:
- Kombination unterschiedlicher Kugeldurchmesser zur Reduktion mechanischer Spannungen durch BGA-Verwölbung
- Einsatz von hochschmelzenden Legierungen, um ein Absinken der Komponente beim späteren Reflow-Prozess zu vermeiden
- Umstellung von bleihaltigen auf bleifreie Kugeln zur Sicherstellung der RoHS-Konformität
- Rückumstellung von bleifreien auf bleihaltige Materialien, etwa zur Erfüllung militärischer Spezifikationen bei nicht verfügbarer Originalbestückung
- Entwicklung und Bestückung individueller Interposer-Lösungen

